ダイボンド技術
| コア技術 | 方式・手段 | 特 徴 | 実 績 |
| はんだダイボンド | リボン・ワイヤ | 主としてシングルチップ、
小面積チップに最適。 高速ダイボンド |
Sn系、AuSn系 |
| ギ酸真空リフロー | ペレット・ペースト | 真空による低ボイド化が可能。 また、フラックスレスにより洗浄工程が不要。 |
ボイド率1%以下 |
| 樹脂ダイボンド | 転写・ディスペンス | シリコーン系樹脂による低応力やエポキシ系 樹脂による低吸水。 導電性・非導電性など様々な樹脂に対応。 |
導電性,非導電性 |
| 焼結ダイボンド | ディスペンス | 高融点鉛はんだやAuSnはんだ代替。 再溶融しない。 |
試作レベル |
| マルチチップ実装 |
― | 両面実装、スタックボンドによる高密度実装に対応。
|
ASIC,MEMSなど |
【ダイボンダ】  |
 |
〈低応力樹脂によるセンサチップダイボンド状態〉 |
|
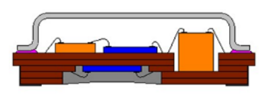 |
|
〈マルチチップイメージ〉 |
【ギ酸真空リフロー炉】 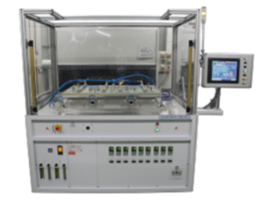 |
 |
〈ギ酸真空リフローによるボイド状態〉 |
|
 |
|
〈ダイレクトリードボンディング〉 |
接合技術
| コア技術 | 方式・手段 | 特 徴 | 実 績 |
| Auワイヤボンド | ボールボンド | 配線方向に制約が無い、ボンディングスピード が速い。 |
線径Φ18~40um |
| Alワイヤボンド | ウエッジボンド | 常温でのボンディングが可能。大電流を流す パワーデバイスなどに最適。 |
線径Φ30~500um |
| 溶接 | 抵抗溶接 | 母材を直接融解させて接合するため、 強度が高い。 |
リードフレーム 同士の接合 |
| 非接触はんだ接合 | レーザ | 非接触加熱により基板への物理的負荷と不良原因を抑制 | Sn系はんだ (基板+端子) |
【Auワイヤボンド】 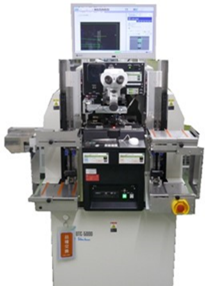 |
 〈ボールボンド〉 |
【Alワイヤボンド】 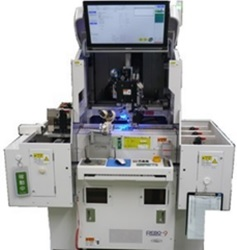
|
 〈ウエッジボンド〉 |
表面実装技術
| コア技術 | 特 徴 | 実 績 |
| SMD実装 | 高速かつ高密度部品実装。 ディスクリートの複合製品に対応するポイントはんだ付け。 用途に応じた基板分割 (ルーター切断、Vカット切断、手割り等)。 |
部品サイズ:0402~ 狭ピッチ:0.15~ |
| ベアチップ・ SMD混載 |
省スペース化によるパッケージの小型化が可能。 |
各種モジュール |
【チップマウンタ】  |
|
〈実装例〉 |
|
  |
|
〈ベアチップ・SMD混載イメージ〉 |
成形技術
| コア技術 | 特 徴 | 実 績 |
| トランスファモールド | 低ストレスでの成形。寸法精度が良い。 複雑な形状にも対応できる。薄肉成形にも対応。 半導体封止に適している。 |
プリモールド/外装モールド (熱硬化樹脂) |
| インジェクションモールド | 外装モールド(二重モールド)に使用。 高速成型が可能。 |
ボイド率1%以下 |
【トランスファモールド】  |
 |
〈プリモールド〉 |
|
 |
|
〈外装モールド〉 |
|
【インジェクションモールド】  |
 |
〈外装(二重)モールド〉 |
外観・特性検査技術
| コア技術 | 特 徴 | 実 績 |
| 外観検査 | 装置および検査ソフトまで内製で対応。 | 現在所内に15台保有 |
| DCテスト | 小信号~高容量デバイスまで対応可能。 絶縁・耐圧・半導体静特性など。 |
高周波半導体 1~100V/max1A パワー半導体 1~2000V/max100A |
| RFテスト | 周波数範囲30MHz~1.2GHz、 出力パワー1W~100W程度まで対応可能。 出力電力・Gain・入力ReturnLoss・高周波等の測定が可能。 |
導電性,非導電性 |
| カスタム | お客様の要求(仕様)に基づいて、 テストシステムを構築します。 |
圧力センサ・Gセンサ・ LEDなど |
【外観検査機】 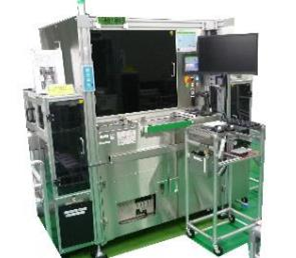 |
【DCテスタ】  |
〈低応力樹脂によるセンサチップダイボンド状態〉 |
【RFテスタ】  |






